无铅回流焊工艺最主要的是对它的温度曲线的调整,无铅回流焊产品质量最主要的影响因素就是对温度的控制把握,下面广晟德回流焊这里分享一下无铅回流焊工艺温度曲线说明。
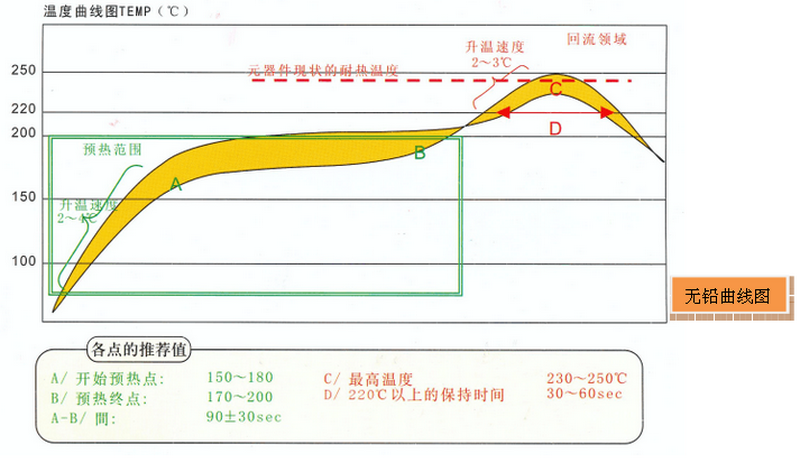
无铅回流焊工艺温度曲线
一般预热区升温速度尽量慢一些(选择数值2-3℃/s),以便控制由锡膏的塌边而造成的焊点桥接、焊球等。
活性区要求必须在(45-90sec、120-160℃)范围内,以便控制PCB基板的温差及焊剂性能变化等因数而发生回流焊时的不良。焊接的最高温度在230℃以上保持20-30sec,以保证焊接的湿润性。冷却速度选择在-4℃/s。
无铅回流焊温度曲线变化说明,焊锡膏的焊剂在温度升至100℃时开始熔化(开始进入活性时期),焊锡膏在活化区的主要作用是将被焊物表面的氧化层去掉,如果活性区的时间过长,焊剂会蒸发挥过快,也会造成焊点表面不光滑,有颗粒状。锡膏在熔点湿度以上(进入回流区)完全熔融的时间大约30-45秒,视该PCB厚度、元器件大小、密度来决定是否延长时间。活性区的温度也可帮助PCB的元器件缓和吸收,使之大小元器件的温差变小,减少功能坏机产生。
进入无铅回流焊炉的大小元器件的温差大约为11.4℃,所以,我们要减少它们差也是从活性区开始控制,最大限度可将温差减少到5-8℃。无铅焊锡膏因考虑到其由多元合金组成,金属的冷却收缩时间不同,为了使焊点能够光亮,除了有其它方法外,快速降温是最有效的方法。